华为研究混合3D芯片堆叠技术,或可绕过美国技术制裁
新智元报道
新智元报道
编辑:时光 拉燕
【新智元导读】华为独立研发的3D芯片堆叠技术,它基于旧节点,却能增加新性能,华为新的芯片封装和连接技术将有何价值?
为什么要开发?



2.5D和3D混合堆叠
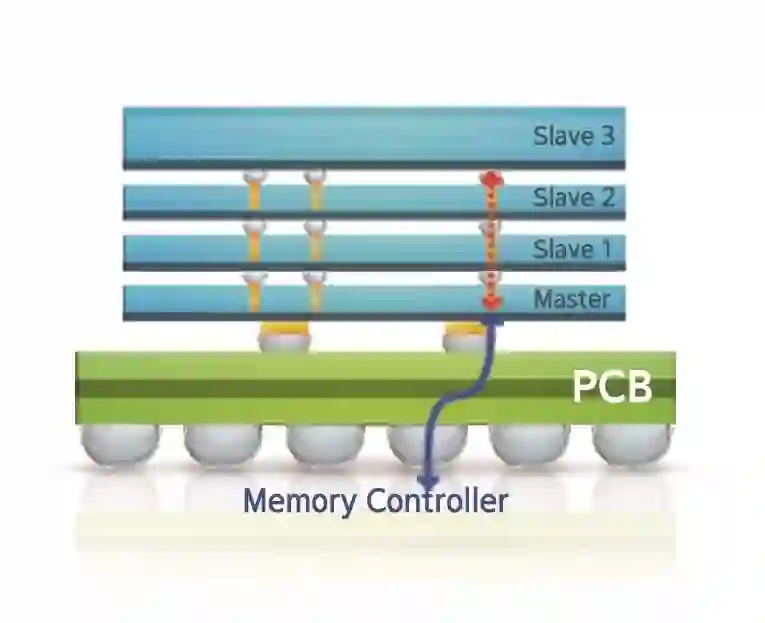
重叠
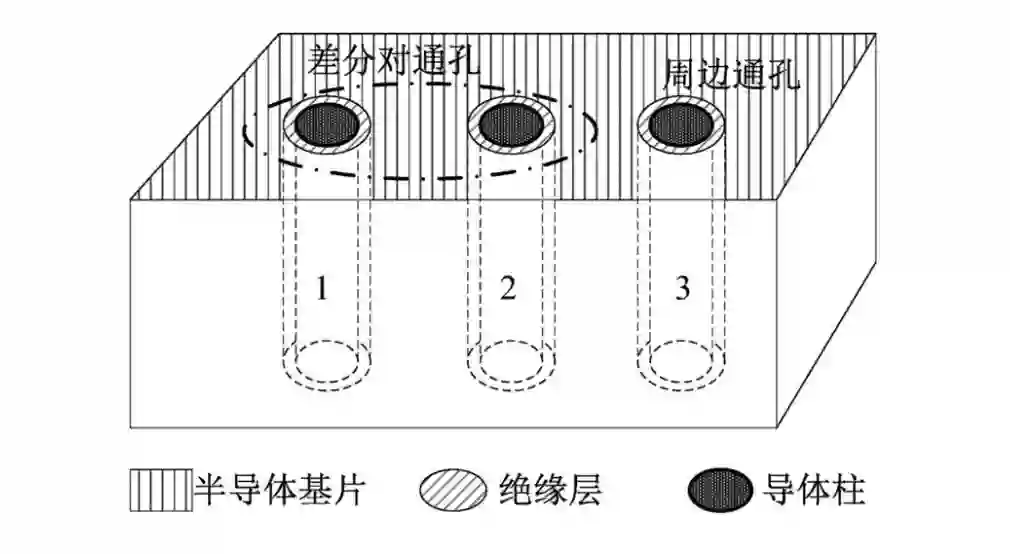
规避美国制裁
登录查看更多
相关内容
Arxiv
0+阅读 · 2022年6月21日







